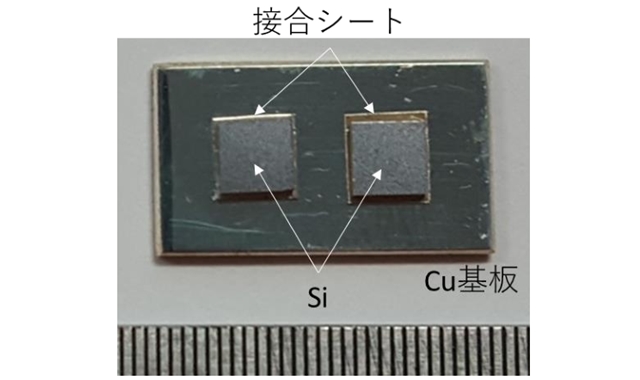
大阪大学は8月30日、同大学の研究グループが次世代パワー半導体接続技術である銀粒子焼結接合において、低温・無加圧化かつ電極を選ばないダイアタッチに成功したと発表した。加えて銀シート接合技術も開発しており、今後は安価な従来の電極構造を変えることなくダイアタッチやシート接合ができるとしている。
同大学の産業科学研究所の菅沼克昭教授が開発した銀粒子焼結接合技術は、低コストかつ、低温、低圧、大気中の条件でダイアタッチが可能であり、さらに250℃を超える耐熱であることから、次世代パワー半導体接続技術として世界で開発が進んでいる。その接続メカニズムは菅沼教授らによりナノレベルで解明されており、200℃程度で大気中の酸素と反応しながらAg-O液体噴火することで金属焼結が進むことが示されている。しかし、この現象は銀のみで生じ、他の金属では不可能である。一方、Si(シリコン)やSiC(シリコンカーバイド)などの半導体、DBC基板などの電極にはニッケルや銅が用いられることが多く、これら電極への接合は高圧を掛けなければならないという課題があった。
これらの課題を解決するため、同研究グループは日本の化学品メーカーであるダイセルとの共同研究により銀の界面形成を活性化する溶剤の開発を進め、より低温の200℃においても多種類の電極を接合できる無加圧焼結接合技術を開発した。この新ペースト(溶剤)では、銀の2倍程度の抵抗値4×10-6Ω・cmという、これまでナノ銀ペーストでしか得られなかった低抵抗値を得られるという。
また従来のパワー半導体プロセスでは、ペーストを用いずシートをダイアタッチ接合材料として使う場合も多数ある。同研究グループは、銀シート表面に簡単な研削加工を施すことで表面活性化させる技術も開発した。この加工組織導入によって、200℃から250℃の低温度域で銀シート表面に瘤状の微細な突起(ヒロック)を多数形成することを確認、新たなシート接合技術への展開を確認したという。シート接合が可能になったことで、適用範囲が一気に拡大する見込みだ。
今回の研究成果により、次世代パワー半導体のSiCやGaN(ガリウムナイトライド)の高性能ダイアタッチが可能になるだけでなく、課題となる耐熱配線に、低温で無負荷、低ノイズの3次元配線を実現できるという。SiCやGaNパワー半導体の本来の性能である低損失大パワー変換が実現するほか、電力変換器の超小型化が可能になり、世界の省エネルギー化、CO2ガス削減への貢献が期待できるとしている。













