- 2017-9-22
- 技術ニュース, 電気・電子系
- 東芝デバイス&ストレージ, 産業技術総合研究所, 窒化ガリウム半導体
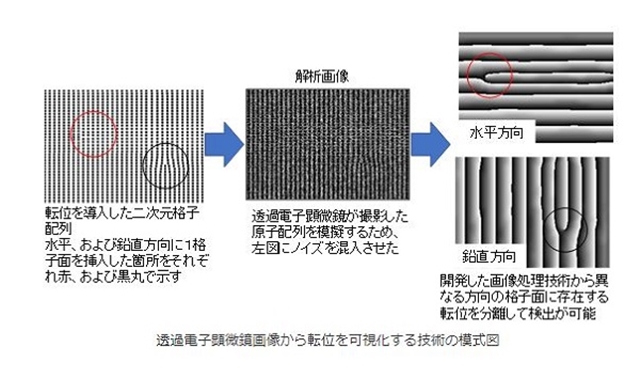
産業技術総合研究所(産総研)は2017年9月21日、東芝デバイス&ストレージと共同で、結晶の透過電子顕微鏡画像から欠陥を検出できる画像処理技術を開発したと発表した。広範囲の透過電子顕微鏡画像から転位分布を評価でき、半導体デバイスの製造プロセス改良に貢献するという。
窒化ガリウム(GaN)半導体は近年、次世代の省エネ用電力変換・制御デバイスとして期待されている。しかしGaNデバイスの製造時に、線状の結晶欠陥である転位がGaN結晶中に発生することがある。デバイス内の転位は、半導体の性能や寿命に大きな影響を及ぼすため、製造時に発生する構造欠陥を精密に制御するプロセス技術の確立が求められてきた。これまで原子レベルの欠陥は、透過電子顕微鏡で撮影した高分解能原子配列画像を人が観察して検出していたが、高倍率にするほど視野が狭くなるため、視野を移動しながらデバイス全体の転位分布を網羅的に評価することは困難だった。
今回、産総研は東芝デバイス&ストレージから、製造プロセス条件の異なるGaN半導体デバイスの透過電子顕微鏡画像の提供を受けて、転位分布の検出に取り組んだ。産総研はこれまで、計測対象の規則的な模様を利用して、橋梁などの大型構造物の変形分布を計測する技術を開発しており、この技術を適用した。今回開発した欠陥検出技術では、転位は格子間隔が近い二つの格子を重ねたときに現れる周期的な模様「モアレ縞」の終点や分岐点として目視でも簡単に検出でき、また画像処理によってモアレ縞の終点や分岐点を自動的に検出して、電子顕微鏡画像全体で転位の数や分布を評価できるとしている。