
GaN半導体結晶の(a)エッチピット像と(b)ラマンマッピング像
産業技術総合研究所は2018年5月22日、名古屋大学と共同で、ラマンマッピング像から窒化ガリウム(GaN)半導体結晶の欠陥を検出する技術を開発したと発表した。欠陥の分布や方向を非破壊で特定することができ、GaN半導体単結晶の改良や歩留まり向上につながることが期待される。
次世代パワーデバイスとして期待されているGaN半導体は、より高性能化/高寿命化するための研究が進められている。その中で、GaN半導体単結晶の構造欠陥である転位を検出するためには、これまでは大型放射光施設を用いた実験や試料を破壊するエッチピット法などを行う必要があったため、より簡便に非破壊で検出できる評価技術の確立が求められていた。
今回開発した技術は、ラマン散乱を応用している。ラマン散乱とは、物質に光が入射したとき、散乱された光の中に強度は非常に弱いが入射した光と波長が異なる光が含まれる現象だ。GaNのラマン散乱スペクトルでは、結晶にひずみがあると、圧縮ひずみでは高波数側、引張ひずみでは低波数側にピークがシフトする。このGaN結晶のピークシフトを0.1cm-1の波数分解能で観測し、わずかなひずみの検出を試みた。
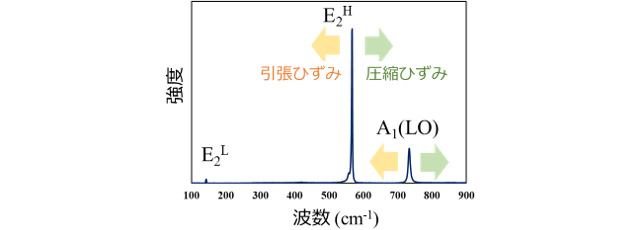
GaN半導体のラマン散乱スペクトル
その結果、従来GaN基板の欠陥評価法として使用されてきた水酸化カリウム溶液によるエッチピット法と比べて、GaN結晶の刃状転位や混合転位の分布や方向を簡便に非破壊で測定できた。
今回開発した技術により、GaN半導体デバイスの製造プロセス改良への貢献が期待される。