- 2022-10-25
- ニュース, 技術ニュース, 機械系
- ABF, EUV, TACMIコンソーシアム, スペクトロニクス, チップレット化, 三菱電機, 半導体パッケージ基板, 味の素ファインテクノ, 東京大学, 極微細レーザー穴あけ, 極端紫外光, 次世代半導体, 深紫外レーザー, 研究
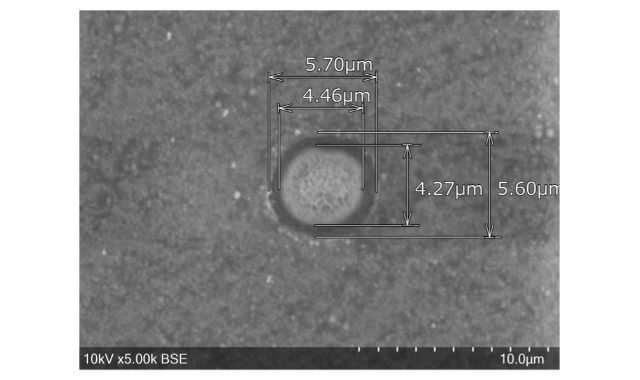
東京大学は2022年10月24日、味の素ファインテクノ、三菱電機、およびスペクトロニクスと共同で、次世代の半導体製造工程に対応する、半導体パッケージ基板への6μm以下の極微細レーザー穴あけ加工技術を開発したと発表した。
現在CPUなどの高度な半導体では、味の素ビルドアップフィルム(ABF)が半導体パッケージ基板のビルドアップ材料として多く用いられている。このABFにレーザーで多数の微細な穴をあけて銅めっきすることで微細配線を形成している。現在は穴径が40μm程度で、加工時のレーザーの波長が長いために、これ以上微細な穴をあけるのは困難だった。しかし、極端紫外光(EUV)リソグラフィ技術の進展によって、半導体の微細化や、別チップで製造した構成要素をパッケージ基板上で組み合わせて実装するチップレット化など、半導体製造の状況が変化しつつあり、ABFへの微細な穴径での加工技術が求められている。
今回の研究では、銅薄膜上に厚さ5μmのABFを配置。これにレーザー微細穴あけ加工を実施した。レーザーはスペクトロニクスが開発した波長266nmでピコ秒のパルス幅の深紫外レーザーを使用。レーザー加工機は、深紫外短パルスレーザーを組み込んだ三菱電機の次世代プロセス用開発機を用いた。さらに、東大が開発した加工プロセスを最適化するサイバーフィジカル型レーザー加工機システムの成果も取り入れた結果、6μm以下の極微細穴あけ加工が可能になった。
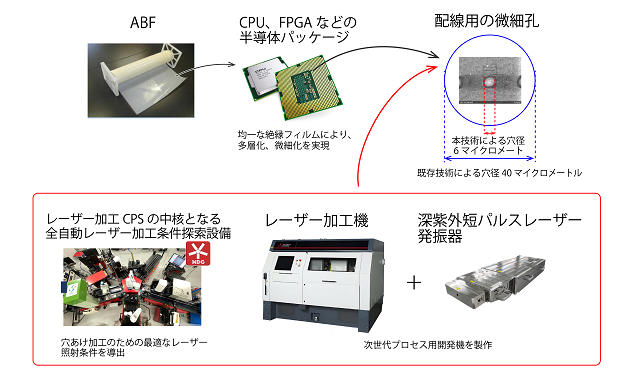
加工能力は1秒当たり数千穴。高品位加工用のパラメーターを用いると、6μmの直径で上面と下面の穴径の比で表されるテーパー度が、品質基準値の75%に達する。これらは次世代の半導体製造におけるパッケージ基板に対する品質要求に応えるものだ。
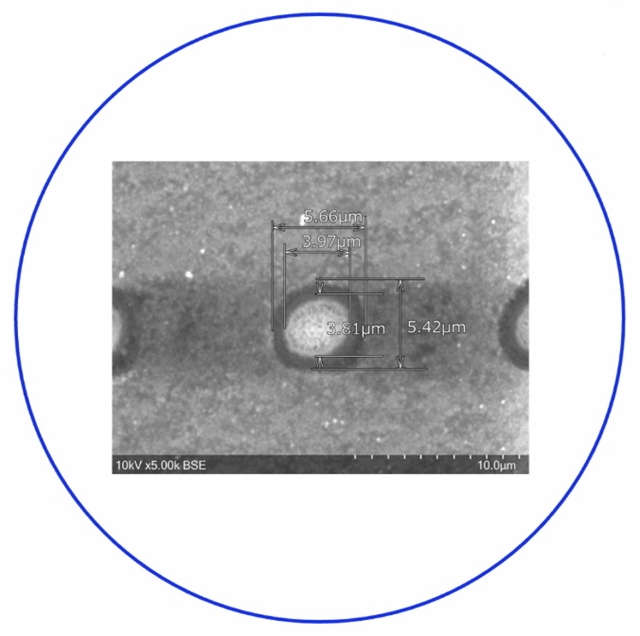
ABFに高速スキャンで6μmの穴をあけたものを電子顕微鏡写真で撮影。
穴の内側で白く見えるのは底面の銅薄膜。写真を囲む青丸は既存技術で用いられている40μm穴に相当するサイズ。
今回開発した加工技術は、微細化や複雑化が進む次世代半導体製造において、チップレット技術やマルチスケールデバイス化などを支える後工程に必要とされている技術だ。電気自動車(EV)開発における先端半導体製造などでの活用が期待されている。
今回、東大が運用するレーザー加工のスマート化を目指す産学官協創拠点「TACMIコンソーシアム」において、半導体製造に関する異なる強みを持つ法人が、業種を超えて連携/開発したことにより、次世代の半導体製造工程に資する技術を開発した。
東大ら4法人は、今後も連携してさまざまな加工ニーズや仕様に合わせたレーザー加工のプロセス条件を素早く見つけ出す技術の開発に取り組む。













