
三井金属鉱業は2018年1月25日、ファンアウト・パネルレベルパッケージ用ガラスキャリア付き微細回路形成用材料「HRDP(High Resolution De-bondable Panel)」を開発し、ジオマテックと量産技術を確立したと発表した。
スマートフォンなどのパッケージ基板には、MSAP(Modified Semi Additive Process)工法による微細配線を形成する材料として、同社の極薄銅箔「MicroThin」が広く採用されている。更に昨今では、極薄銅箔を用いたSAP(Semi Additive Process)工法による微細配線化も実用化されているが、これら工法の限界領域を超えるものとして期待されているのが、RDL 1st(Re-Distribution Layer 1st)工法でのファンアウト・パネルレベルパッケージだ。RDL形成後に半導体チップ実装を行うことで良品チップのロスリスクを回避でき、600×600mmなどのパネルレベルで生産ができるため、高歩留まりかつ低コスト化が可能となる。
今回、同社が開発したHRDPは、ガラスキャリア表面上に多層薄膜を形成した構造となっており、高い平坦性を有するガラスキャリア上に形成された極薄の「メッキ用シード層」によって超微細なRDLをパネルサイズで形成でき、「剥離機能層」によって260℃の熱負荷後でも安定な機械的ガラスキャリアの取り外しが可能だ。
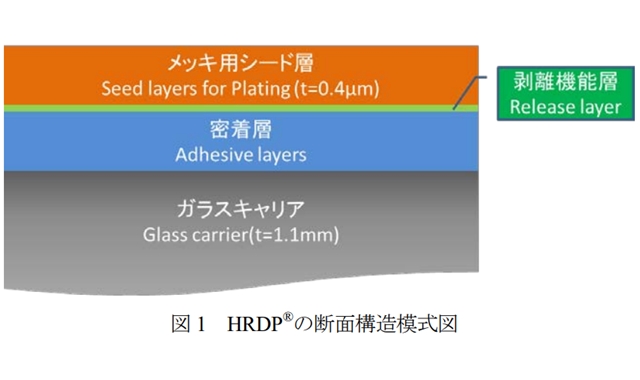
同製品を用いれば、配線の幅と隣り合う配線同士の間隔がそれぞれ2μm(L/S=2/2μm)レベルの微細配線を形成できるといい、今後は薄膜成膜技術を持つジオマテックと協働し、量産を図るという。