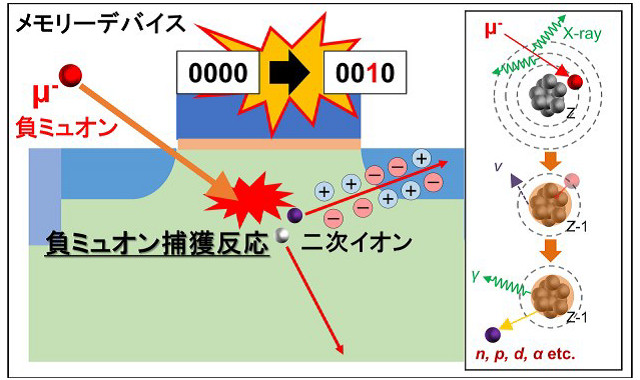
負ミュオンが半導体メモリデバイスに入射し、負ミュオン捕獲反応で発生した二次イオン(陽子やヘリウム等)により電荷が付与されて、ビット情報反転が生じる
九州大学や大阪大学などの共同研究グループは2018年5月29日、J-PARC物質・生命科学実験施設(MLF)内のミュオン実験装置MUSEで半導体デバイスに対する正および負ミュオン照射試験を行い、正ミュオンに比べて負ミュオンの方がメモリ情報のビット反転の発生確率が高くなることを実験的に初めて明らかにしたと発表した。
IoTの普及により、スマートフォンやパソコンだけでなく、冷蔵庫などの家電にもコンピューターが搭載されるようになった。近年、これらの電子機器の誤作動の原因として、ソフトエラーという現象が注目されている。ソフトエラーとは、電子機器が放射線(宇宙線)に曝されて半導体デバイスのビット情報が反転するなどして生じる、一過性の誤作動や故障のことだ。
ソフトエラーの原因となる宇宙線は、絶えず地上に降り注いでいる。宇宙線は、主に中性子やミュオンで構成されている。ミュオンは、電気素量に等しい電荷を持ち、電子の約200倍の質量を持つ、素粒子レプトンの1つ。透過力が高いため、電子機器の中にも到達する。
半導体デバイスの微細化や低消費電力化が進むにつれ、半導体デバイスの放射線耐性は低下。従来から指摘されている宇宙線中性子によるソフトエラーの対策は進められているが、宇宙線ミュオンに起因するソフトエラー発生の可能性も指摘され始めている。
ミュオンには正の電荷をもつ正ミュオンと負の電荷をもつ負ミュオンがあり、正ミュオン照射実験結果の報告は数例あったものの、負ミュオン照射試験の報告はなかった。先行のシミュレーション研究では負ミュオンは原子核に捕獲される物理過程によって、正ミュオンよりソフトエラーの影響が大きいことが予想されており、実験的検証が望まれていた。
今回の研究では、MUSEで世界最高強度の正および負ミュオンビームを発生させ、半導体デバイスの照射試験を実施。65nm 設計ルール(回路の線幅)の12メガビットSRAMに低エネルギーミュオン(運動量34~44MeV/c)を照射し、入射運動量やデバイスにかける電圧を変えて、メモリセルのビット反転発生確率を測定した。
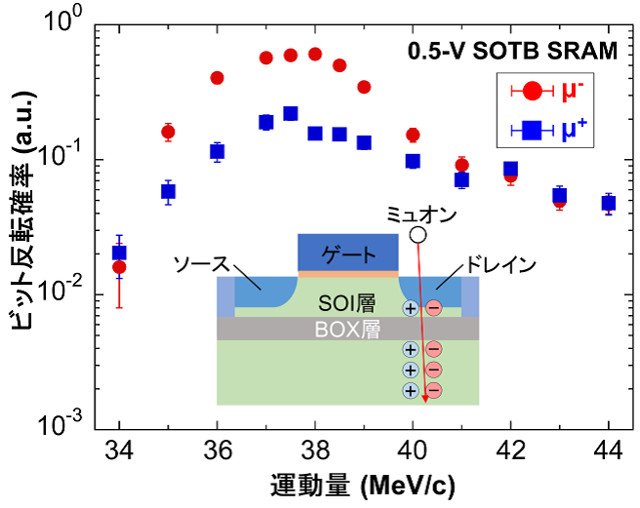
測定結果
その結果、負ミュオンの方が正ミュオンに比べてビット反転発生率が高くなることを実験的に初めて観測した。粒子・重イオン輸送計算コードPHITSを用いたデバイス内のミュオン挙動シミュレーション結果と比較すると、停止位置での負ミュオン捕獲反応により発生した二次軽イオン(陽子やヘリウム)と反跳核イオンによる局所的な電荷付与が、ミュオン自身が直接電離することによる電荷付与に比べて十分大きいことが原因だと分かった。
今後は、宇宙線ミュオンに起因するソフトエラーの発生機構を、実験やシミュレーションによりさらに解明し、エラー率推定のための基盤技術(国内ミュオン施設を活用した試験技術と先端シミュレーション技術)を開発していくという。