- 2018-2-5
- 化学・素材系, 技術ニュース
- 微酸素雰囲気で焼結可能な銅ナノ粒子, 日清エンジニアリング, 次世代パワー半導体, 高周波熱プラズマ法
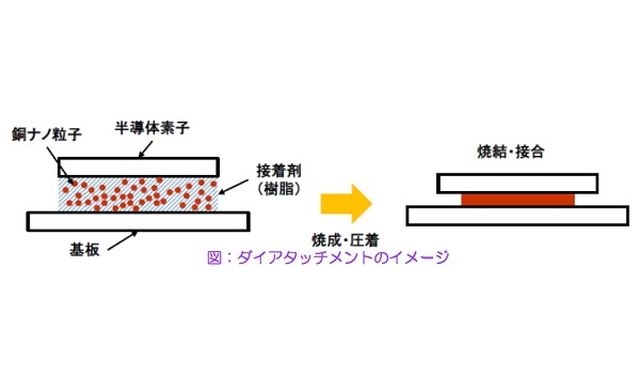
日清エンジニアリングは2018年2月2日、次世代パワー半導体の接合に対応した「微酸素雰囲気で焼結可能な銅ナノ粒子」を開発したと発表した。
パワー半導体の半導体素子を基板に接合する材料には、主にはんだなどの低融点材料が用いられている。しかし、市場成長が見込まれる次世代パワー半導体では、高温条件での使用が想定されるため、次世代パワー半導体の接合に対応した材料が求められていた。
そこで昨今、その材料として金属ナノ粒子が注目されている。金属粒子は、焼結によって接合して導電性が発現するが、半導体素子や基板にダメージを与えない温度で焼結することは難しかった。しかし、ナノ粒子を用いると、焼結温度が低下し、また、焼結後は金属の融点までの耐熱性が得られる。
そこで同社は、銅ナノ粒子に着目。高周波熱プラズマ法を用いて表面保護材に改良を加えることで、安定して取り扱うことができる銅ナノ粒子を開発した。同材料は、100ppm程度の酸素濃度である微酸素雰囲気でも焼結可能なため、還元性ガスを用いず、市販の窒素発生機で焼結条件を満たす。また、300℃で焼成した場合の電気抵抗率は10-5Ω・cmで、従来のはんだと同程度の導電性が得られる。さらには、マイクロ粒子と結合するため、製造コストの低い銅マイクロ粒子と混合して使用することで、導電性を確保しながら低コストを実現できる。

同社は今後、同材料を積極的に展示会などで紹介し、少量からの受託加工を行う予定だ。