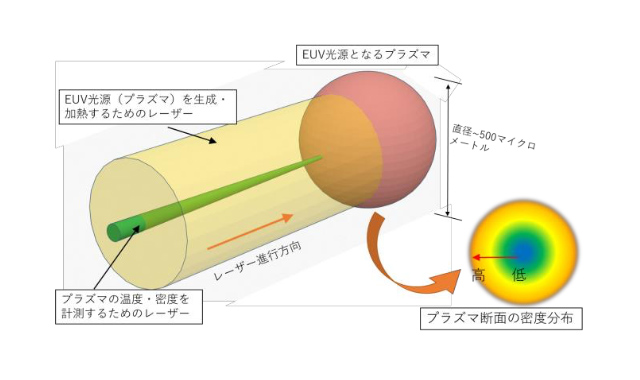
EUV露光光源用プラズマ生成の概要
九州大学の富田健太郎助教、ギガフォトンなどによる研究グループは2017年10月3日、次世代の半導体露光(リソグラフィ)で使われる極端紫外(EUV)光源プラズマの温度や密度の空間構造を世界で初めて明らかにしたと発表した。
EUV露光とは、非常に短い波長(13.5nm)の光を用いるリソグラフィ技術で、従来技術では難しかった半導体の微細加工を可能にする重要技術といわれている。しかしその実用化・普及には、必要な波長域で圧倒的に強く光る光源(温度が30万度程のプラズマ)が必要となる。
今回の研究では、レーザートムソン散乱法という手法を用いて、5ナノ秒の時間分解と、20μmの空間分解で、EUV光源の温度や密度の2次元空間分布計測を可能にした。その結果、明るいEUV光源では、中心部でプラズマの密度(電子密度)が低く、周辺部で密度が高い「中抜け」構造であることがわかった。明るいEUV光源のこの特徴的な密度構造が、優れた光源のために重要であることを示した。
同研究グループでは、光源構造が解明されたことで、今後EUV露光装置の高出力化の促進が期待されるとしている。