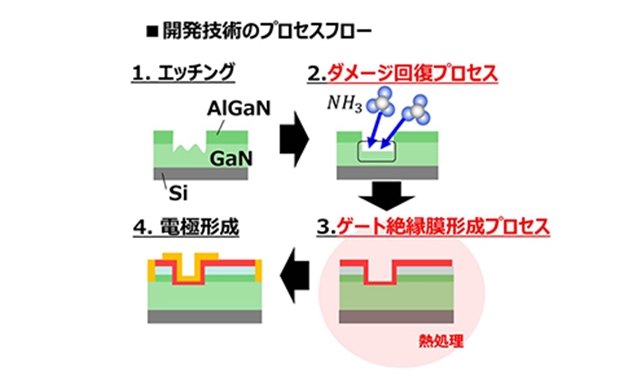
東芝は2017年12月7日、次世代の半導体パワーデバイスとして期待される窒化ガリウム(GaN)パワーデバイス向けに、ゲート絶縁膜プロセス技術を開発したと発表した。これにより閾値電圧変動などの特性変動を大幅に低減でき、この技術を適用したGaN-MOSFET(金属酸化膜半導体電界効果トランジスタ)によりGaNパワーデバイスの信頼性が向上し、さらなる普及が期待できるとしている。
スイッチング電源やサーバ電源など電子機器に用いられる電源には、シリコン(Si)を用いたパワーデバイスが使用されているが、より優れた材料物性を有する窒化ガリウム(GaN)を半導体材料とするトランジスタを使用することで、電源の高効率化が期待されている。GaN-MOSFETは高速性に優れるものの、従来技術では閾値電圧の変動が課題となり、実用化には至っていなかった。
同社は、GaN-MOSFETの閾値電圧変動を起こす要因が、ゲート絶縁膜中の不純物トラップにあることを突き止め、ゲート絶縁膜中の不純物を極限まで低減するプロセス技術を開発した。GaN半導体加工時のダメージを回復する処理を施した上で、形成したゲート絶縁膜に熱処理を加えることで、ゲート絶縁膜中の水素などの不純物を低減できる。これにより、従来技術と比較して閾値電圧変動が大幅に低減し、世界トップクラスのゲート信頼性を実現できるとしている。