- 2019-3-7
- ニュース, 化学・素材系, 製品ニュース, 電気・電子系
- コアシェル型接合材料, コアシェル型粒子, サブミクロン銅粒子, 三菱マテリアル, 低温焼結性, 次世代型パワーモジュール, 液相焼結, 焼結型接合材料, 焼結型銅接合材料, 素子接合材料, 金属間化合物接合, 鉛フリーはんだ, 銅粉末表面酸化膜除去, 高出力モーター電源制御用インバータ

(左)サブミクロン銅粒子(右)コアシェル型粒子
三菱マテリアルは2019年3月6日、次世代型パワーモジュール向けに2種類の焼結型接合材料を開発したと発表した。
ハイブリッド自動車の普及により、200℃以上でも動作可能なSiC(炭化ケイ素)やGaN(窒化ガリウム)等の高温半導体素子を用いた次世代型パワーモジュールが注目を集めている。しかし、このような高温環境下では、従来の素子接合材料である鉛フリーはんだは、融点が200℃程度で耐熱性が不十分だった。
そこで三菱マテリアルは、低温焼結性を持つサブミクロン銅粒子を用いた接合材料と、銅に錫を被膜させたコアシェル型粒子を用いた接合材料の、2種類の焼結型接合材料を開発。従来品の課題を解決しつつ、極めて高い耐熱性を実現した。
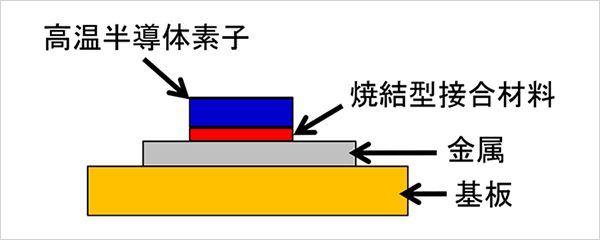
高温半導体素子使用時の模式図
サブミクロン銅粒子を用いた焼結型銅接合材料では、低温で分解する有機分子をコーティング。従来必要だった銅粉末表面酸化膜除去のため活性ガスでの還元処理が不要となり、低温/不活性雰囲気での接合が可能となった。
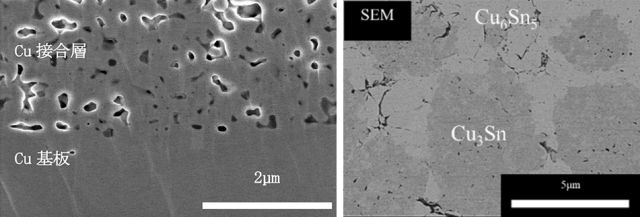
焼結型銅接合材料(左)とコアシェル型接合材料(右)の接合層の断面SEM像
コアシェル型粒子を用いたコアシェル型接合材料では、液相焼結による金属間化合物接合で課題だった長時間の熱処理を解決。コアシェル構造による錫と銅の反応活性化により、短時間での接合が可能となった。
同製品は、高出力モーター電源制御用インバータをはじめとする次世代型パワーモジュールへの採用が期待されるとしている。