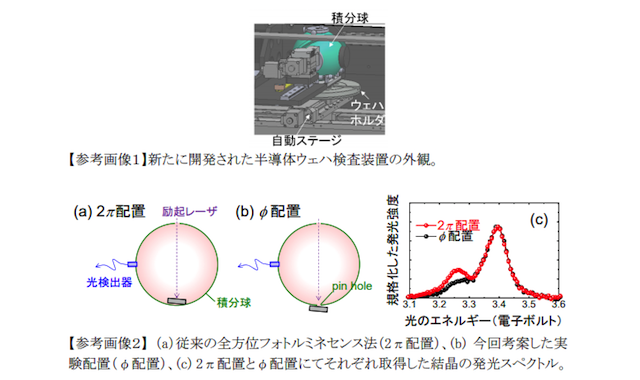
東北大学多元物質科学研究所は2019年5月24日、小島一信准教授、秩父重英教授、浜松ホトニクスの池村賢一郎氏が共同で、分光技術に基づく半導体ウェハ検査技術を新たに開発したと発表した。この技術は、窒化ガリウム(GaN)ウェハの高速かつ高感度な検査を可能にし、検査時間の大幅な短縮に寄与する。
GaNは直接遷移型半導体と呼ばれ、外部から励起を受けると特有の光を放出する。この時、結晶欠陥の少ない結晶ほど強く発光するため、発光量か発光効率を指標とすれば結晶の品質管理が可能となる。そこで小島准教授らは今回、半導体結晶の高精度な発光効率計測法である全方位フォトルミネセンス法(ODPL法)を応用し、積分球を核とする分光技術を駆使した半導体ウェハ検査手法を確立した。
小島准教授らが最初に着目したのはODPL法(2π配置)だ。これは、積分球に試料を配置し、結晶から放出された光を全方位にわたって集め、発光量や効率を絶対測定する方法である。しかし、この手法には積分球よりも大きな結晶の評価が難しいという問題があった。そのため、小島准教授らはODPL法(φ配置)という手法を考案した。この手法では、積分球に空けたごく小さな穴から試料の発光を測定する。
通常、積分球の外に結晶がある場合、全ての光の検出はできない。しかし、ある光のエネルギーよりも大きなエネルギー領域(この場合3.31電子ボルト)に限定すると、2π配置とφ配置によって得られる光のスペクトルや強度はほぼ完全に一致する。3.31電子ボルトは結晶の基礎吸収端エネルギーと呼ばれ、このエネルギーより大きなエネルギーの光は結晶に完全に吸収される。よって、基礎吸収端エネルギーより大きなエネルギーの光は、結晶の上方向にしか放出されず、結晶が積分球の外にあっても、全ての光がピンホール経由で積分球にて検出される。
ODPL法(φ配置)は、試料の大きさへの制限がないため、大型GaNウェハの高速検査をはじめ、評価/検出の難しい欠陥種の検査にも役立つ。例えばウェハを自動ステージにて少しずつ移動させ、ウェハ面内の各点において発光量や効率を計測することで、欠陥濃度の大小関係を非破壊/非接触のままウェハ全面を検査できる。東北大学は「本研究は、GaNウェハ上に作製されるパワートランジスタやLED、半導体レーザー、太陽電池など、さまざまな半導体デバイスの開発/製造を加速させるもの」としている。