- 2019-9-16
- 化学・素材系, 技術ニュース, 海外ニュース
- Journal of Materials Chemistry C, ブルックヘブン国立研究所, 光学リソグラフィー, 原子層堆積(ALD), 学術, 有機無機ハイブリッド型レジスト材料, 極紫外線リソグラフィー(EUVL), 電子ビームリソグラフィー(EBL), 高分子ポリメチルメタクリレート(PMMA)
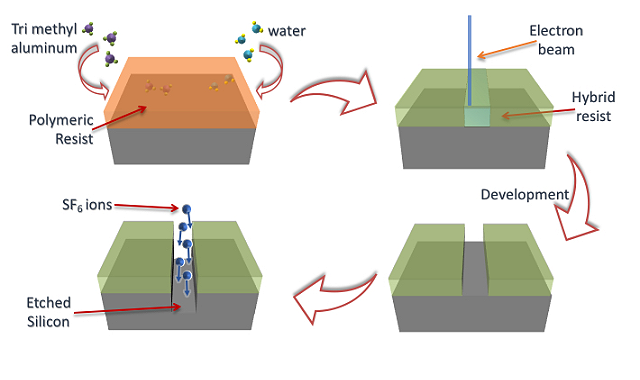
浸透合成技術を用いた、PMMAと酸化アルミニウムの有機無機ハイブリッドレジスト材料の作成方法
ブルックヘブン国立研究所の研究チームが、次世代エレクトロニクス向けに、高解像度パターンを転写できる、有機無機ハイブリッド型レジスト材料を考案した。これまでより高いコントラストやアスペクト比が得られ、30nmレベルの解像度を達成できる。研究成果が、2019年7月8日の『Journal of Materials Chemistry C』誌にオンライン公開されている。
従来の光学リソグラフィーによるICチップ製造では、その解像度はレジストを露光する光の波長によって制限されるため、パターンの微細化には限界があった。可視光ではなく非常に短い波長を使う電子ビームリソグラフィー(EBL)や極紫外線リソグラフィー(EUVL)であれば、この限界を突破することができる。
EBLにおけるレジストとして、一般的には高分子ポリメチルメタクリレート(PMMA)が用いられている。ところが超微細なパターンをシリコン上でエッチングすると、エッチングの凹凸が崩れてパターン形状が劣化し始め、必要なコントラストやアスペクト比を達成できなくなる問題がある。そのため、EBLやEUVLを用いたパターン微細化には、より堅牢なレジスト材料が必要となる。
研究チームは、最近開発された浸透合成技術を用いて、PMMAに酸化アルミニウムを結合する有機無機ハイブリッドレジストを作成し、高コントラスト高アスペクト比の高解像度パターンを形成できることを実証した。原子レベルで薄膜を積層できる原子層堆積(ALD)システムを用いるこのプロセスでは、まずPMMAの薄膜で被覆された基板をALDチェンバーに装入する。そこにアルミニウム前駆体蒸気と水蒸気を導入して、PMMA中の微細な分子細孔に拡散、高分子鎖において酸化アルミニウムを形成させるというものだ。
EBLによるリソグラフィーの結果、エッチングパターンのコントラスト比が顕著に向上し、標準PMMAレジストより約6倍高いことが確認された。ハイブリッドレジストではエッチング速度が抑えられてエッチング選択性が高くなることで、レジストが形状劣化する前に、シリコンを適正にエッチングできるためだ。さらに17程度と高いアスペクト比のパターン形状、および30nmレベルの高解像度を実現できることも示された。
これまでに提案されているハイブリッドレジスト材料では、強い電子照射や、複雑な化学合成手法、または高価な組成が必要であり、大量生産に対して適しているとは言えなかったという。研究チームは今回、「既存のレジスト、安価な金属酸化物、そして殆ど全てのナノ加工施設にあるような一般的な装置を用いた」と語り、大量生産に適していると期待している。今後、研究チームは、大量生産に向いているEUVLに対する、ハイブリッドレジストの適用性について研究を継続する予定である。
関連リンク
Enhancing Materials for Hi-Res Patterning to Advance Microelectronics