- 2023-3-22
- ニュース, 化学・素材系, 製品ニュース
- TGV, アスペクト比, ガラスコア基板, ガラス貫通電極, コンフォーマルタイプ, ファインピッチ, 信号伝送, 半導体チップ, 大日本印刷, 次世代半導体パッケージ, 貫通電極, 金属配線
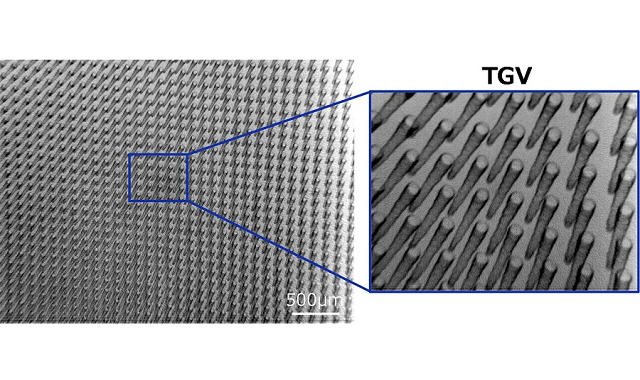
大日本印刷(DNP)は2023年3月20日、次世代半導体パッケージ向けのガラス貫通電極(TGV)ガラスコア基板を開発したと発表した。
半導体に対するさらなる高性能化や信頼性向上が求められる中、異なる機能の半導体チップを1つの基板上に高密度で実装して処理速度を向上させる次世代半導体パッケージが注目されている。しかし、その実現のためには、GIP(Glass Interposer)などのパッケージ中継基板の電極形成技術において、より狭く配線するファインピッチ化や、パッケージの大面積化などが困難だという課題があった。
今回開発したガラスコア基板は、ガラスの表裏に形成された微細な金属配線を電気的に接続するのに必要なTGVを持ち、貫通孔の側壁に金属層を密着させたコンフォーマルタイプである。同社が新たに開発した工法によってガラスと金属の密着性を向上。ファインピッチ化と高信頼性を実現した。
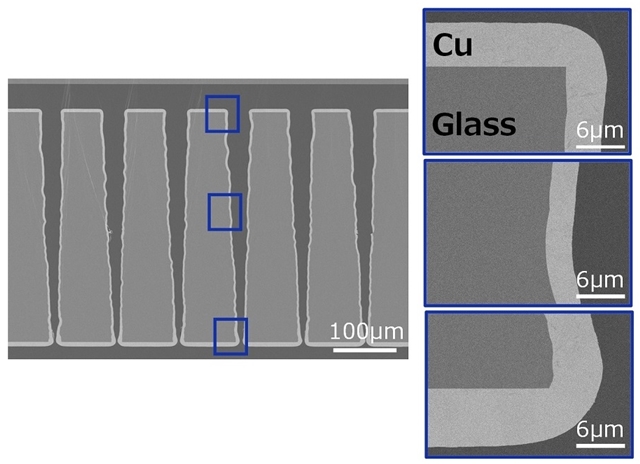
ガラスコア基板の断面画像<ガラスに密着した金属層(Cu)がわかる>
また、一定の面積で大容量の信号伝送するためには高いアスペクト比の貫通電極であることが望ましいが、今回開発した基板のアスペクト比は9以上。そして、微細配線形成のための十分な密着性を持つ。使用するガラスコア基板の板厚にも制限がないため、反りや剛性、平たん性に関して設計自由度が高まり、パッケージの大型化も可能である。
今後はパネルサイズ510×515mmへのスケールアップを進め、2027年度には50億円の売り上げを目指す。