- 2021-5-6
- 技術ニュース, 電気・電子系
- GaN半導体, GaN(窒化ガリウム), 多光子励起フォトルミネッセンス法, 大阪大学, 研究, 結晶欠陥, 貫通転移, 非破壊検査
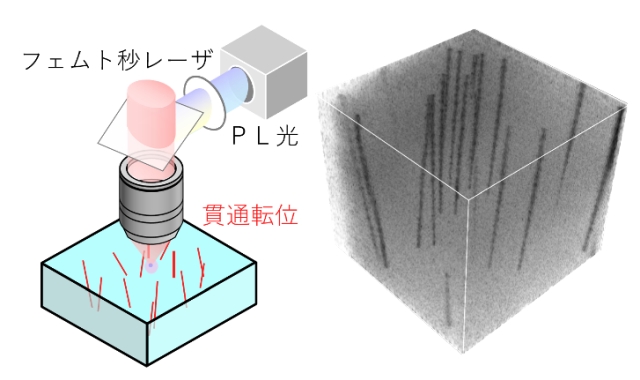
大阪大学は2021年4月28日、同大学院工学研究科の研究グループが、多光子励起フォトルミネッセンス法を用いて窒化ガリウム(GaN)半導体の貫通転位という欠陥を観察し識別する技術を開発したと発表した。半導体を一切加工せずに検査が可能になるため、今後の半導体の高品質化や生産の効率化にもつながる成果だと期待されている。
研究グループは、超短パルスレーザーを物質に照射して、放出される光(PL光)を検出する多光子励起フォトルミネッセンス法という検査方法を用いて、GaN半導体を観察。そこから得られる情報を統計的に分類した。その結果、色の濃淡や貫通転移の形状によって、貫通刃状転位、貫通螺旋転位、貫通混合転位といった欠陥の状態まで識別できることがわかった。
貫通転移は、半導体の中の結晶を貫通する線状の欠陥で、種類や密度によってデバイスに悪影響を及ぼすことがある。現在は、エッチピット法など結晶表面を薬剤で処理して欠陥の有無を調べる方法が主流だが、こうした方法は試料の加工が必要になる。今回の検査結果はエッチピット法とよく一致し、精度は同レベルだった。
GaN半導体は、次世代半導体として期待されている半導体の1つで、さまざまな電子機器の省エネや高性能化への貢献が期待されている。しかし、貫通転位などの結晶欠陥が多いのが欠点で、半導体結晶の高品質化が課題となっている。
今回の成果によって、GaN半導体の非破壊検査の精度を著しく向上させられる。さらに、貫通転位の分布や結晶中の伝播挙動などのさまざまな情報を把握して、ウエハー製造工程や薄膜成長工程にフィードバックすることで、結晶の高品質化への貢献も期待できるという。