- 2022-3-15
- ニュース, 技術ニュース, 電気・電子系
- はんだ, トッパン・フォームズ, プリントエレクトロニクス, 大阪大学, 大面積, 接合強度, 研究, 銀塩インク, 銀塩焼結接合, 銅基板
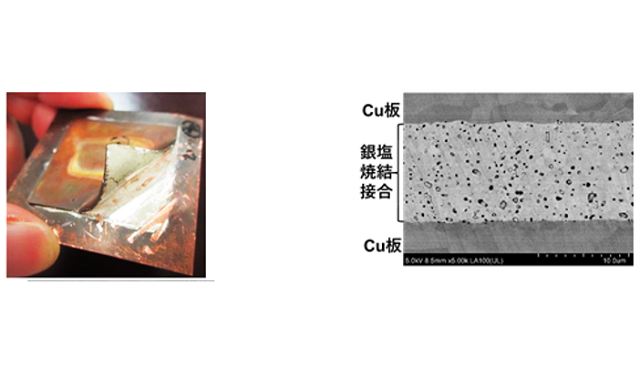
本技術によって接合された銅板(左)とその接合断面(右)
大阪大学は2022年3月14日、トッパン・フォームズと共同で、新たな銀塩焼結接合技術を用いた、銅基板同士の大面積接合に成功したと発表した。
省エネ対応などで期待されている次世代パワー半導体では、半導体の小型化が進むと電流が密になり、動作中の温度が高くなってしまう。従来接合材料にははんだが多く用いられてきたが、耐熱性や熱伝導性に優れた銀が新たな接合材料として採用され始めている。
パワー半導体製品の組み立てには、基板やヒートシンクなど向けにチップサイズなどよりも大きな面積の接合が必要になる。しかし銀による接合の場合、接合面積が大きくなるほど接合材に含まれる溶剤などが残留したり、銅を接合する場合に途中で酸化されてしまうという問題があった。
同大学らは今回、プリントエレクトロニクスで使用する銀塩インクを接合剤として転用。銀塩インクは、紙やプラスチックなどへの配線形成用に開発された材料のため、不純物が残留しにくい成分で構成されている。この銀塩インクを乾燥した後に熱圧を加えることで、大面積(35×35mm)の銅板を接合することに成功した。
接合強度は50MPa以上で、はんだによる接合の2倍以上の強度を持つことが分かった。また、前処理(乾燥)の条件を最適化することで銀焼結層が緻密になり、酸素の内部侵入が抑えられることで、銅との接合界面が酸化されずに金属結合していることも確認できた。
熱伝導率が高い銅を、同じく熱伝導率が高い銀によって大面積接合ができるようになれば、自動車や電気鉄道、通信、再生エネルギー分野などで使用される電力変換器などで発生する熱を効率的に逃がすことができるようになり、機器故障の予防や冷却に使用するエネルギーの削減につながる。
また、本技術では、これまでのように銅をめっき処理しなくても通常の環境(大気下)での接合を達成しており、接合プロセスの簡素化に貢献するという。













