- 2023-10-20
- 技術ニュース, 機械系, 海外ニュース
- 3Dスタッキング技術, インダクタ, インテル, ガラス基板, コンデンサ, シリコン・パッケージ, セラミック材料, ダイ・パッケージング技術, チップアーキテクト, トランジスタ, 人工知能(AI), 光インターコネクト, 半導体, 学術, 有機基板, 有機材料
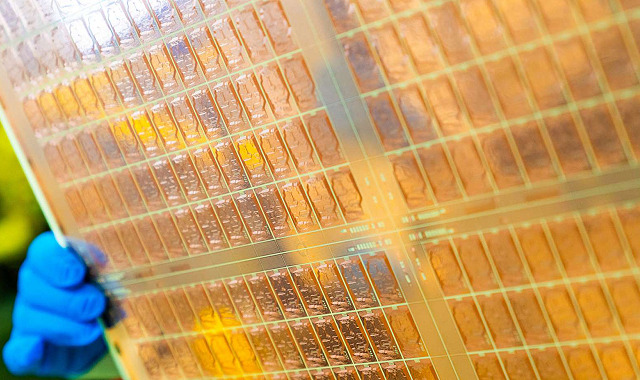
Credit:Intel Corporation
米Intelは2023年9月18日、2020年代末に向けたガラス基板の商業化の進捗状況を発表した。同社によれば、ガラス基板は「次世代の半導体にとって実行可能で不可欠な次のステップ」であり、より多くのトランジスタをパッケージ内に実装することを可能にするという。
Intelは10年以上にわたって、従来の有機基板に代わるガラス基板の信頼性を研究し、評価してきた。1990年代にセラミック材料から有機材料へのパッケージ移行で業界をリードし、業界初のアクティブ3D積層テクノロジーである、高度な組み込みダイ・パッケージング技術を発明するなど、次世代パッケージングを実現してきた長い歴史がある。
同社によれば、有機材料を使用したシリコン・パッケージは、より多くの電力を消費し、収縮や反りなどの制限がある。2030年末までにトランジスタの実装を拡張できる限界に達する可能性が高いと述べている。これに対してガラス基板は、超低平坦性、優れた熱的・機械的安定性といった特徴的な特性を備えており、基板内の配線密度を大幅に向上できる。これらの利点により、チップアーキテクトは、人工知能(AI)のようなデータ集約型のワークロード向けに、高密度で高性能なチップパッケージを作成できるようになる。Intelは、2020年代の後半に完全なガラス基板ソリューションを市場に提供する予定であり、ガラス基板によって、2030年以降もムーアの法則を継続して更新できるようになるとしている。
また、ガラス基板の高温耐性は、光インターコネクトをシームレスに統合し、インダクタやコンデンサを高温処理でガラスに埋め込む能力を与えるため、電力供給や信号配線の設計ルールをどのように設定するかについて、チップ設計者に柔軟性を提供する。これにより、はるかに低い電力で必要とされる高速信号伝達を実現しながら、より優れた電力供給ソリューションが可能になる。このような多くの利点により、2030年までにパッケージ上に1兆個のトランジスタを集積することが可能になるとしている。
関連情報
Intel Unveils Industry-Leading Glass Substrates to Meet Demand for More Powerful Compute