- 2023-11-17
- 化学・素材系, 技術ニュース
- GeO₂, GeO₂エピ製膜技術, GeO₂薄膜, Patentix, PhantomSVD, PhantomSVD法, ファントム局所的気相成長, 二酸化ゲルマニウム, 研究, 立命館大学, 立命館大学総合科学技術研究機構, 製膜
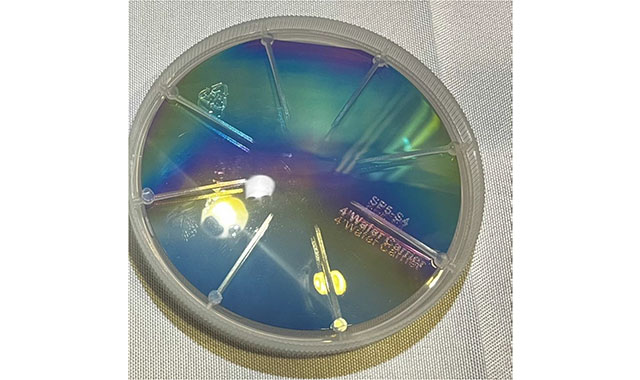
立命館大学総合科学技術研究機構の金子健太郎教授らは2023年11月16日、Patentixと共同で、世界で初めて、Phantom SVD(ファントム局所的気相成長)法により、二酸化ゲルマニウム(GeO2)を4インチSiウエハ上に製膜することに成功したと発表した。大面積ウェハへの二酸化ゲルマニウム薄膜の製膜可能性を示す大きな成果となる。
炭化ケイ素(SiC)や窒化ガリウム(GaN)と比べ、ルチル構造二酸化ゲルマニウム(r-GeO2)は大きなバンドギャップを持つことから、r-GeO2によるトランジスタやダイオードは、高耐圧、高出力、高効率(低損失)という優れたパワーデバイス特性を備えることが期待されている。
Patentixでは、独自に開発したPhantom SVD法を用いて製膜している。Phantom SVD法は安全安価な原料を用いることができ、コストパフォーマンスに優れている。また、結晶成長が、従来の霧(ミスト)状にした溶液を用いるCVD法とは異なる原理ででき、より安全、安心な薄膜合成ができる。
今回、GeO2をPhantom SVD法により、4インチSiウエハ(100)上に製膜することに世界で初めて成功。GeO2薄膜の大面積化の可能性を示した。今後、GeO2薄膜の電気特性評価や、膜中に存在する欠陥評価等を実施し、高品質なGeO2エピ製膜技術の開発を進めていく。













