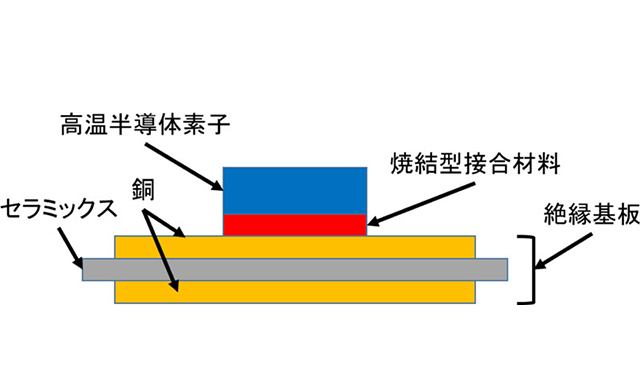
三菱マテリアルは2020年1月8日、次世代型パワーモジュール用絶縁基板で使用される銅部材に、無加圧で高温半導体素子を直接接合できる焼結型接合材料を開発したと発表した。従来品と同等の接合強度と耐熱性を発揮する。
これまでは、炭化ケイ素(SiC)や窒化ガリウム(GaN)などの高温半導体素子を次世代型パワーモジュール向け銅部材に接合する際、金や銀などの貴金属めっきを基板表面に施し、加熱しながら加圧する必要があった。
新たに開発した焼結型接合材料は、貴金属をめっきすることなく基板表面の銅部材に無加圧で接合でき、接合強度30MPa以上、耐熱性200度以上と従来品と同等の性能を発揮する。
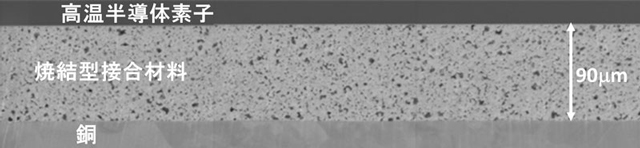
さらに、パワーモジュールで採用されることの多い高温半導体素子のサイズである10mm角で、ボイドが従来品より大幅に少ない接合層を実現した。ハイブリッド自動車や電気自動車の高出力モータ電源制御用インバータをはじめとする、高い耐熱性と信頼性が求められる次世代パワーモジュール向けの焼結型接合材料としての利用拡大が見込まれる。