
パナソニックは2021年3月2日、「高耐熱性二次実装補強 サイドフィル材料 CV5797U」を製品化し、同月より量産を開始すると発表した。
車載用デバイスの高機能化に伴い、半導体パッケージの大型化や搭載する実装部品を高密度化したことによる配線の微細化が進んでおり、半導体パッケージの発熱量増加や外部接続端子の面積減少などが原因ではんだ接合部にクラックが生じることが課題となっている。
今回製品化した材料は、同社独自の樹脂設計技術を採用しており、ガラス転移温度(Tg)が160℃と高い一方で、熱膨張係数(CTE)を14ppmと低く抑えた。マザーボードと半導体パッケージ間の熱収縮差を抑えてはんだ接合部にかかる応力を低減することで、はんだ接続部のクラックを防止できる。
また、同社は−55〜125℃で温度サイクル試験を実施し、6000サイクルでもはんだ接合部の剥離やクラックが生じないことを確認した。
さらに、独自の樹脂反応制御技術を採用しており、常温でのポットライフが同社従来品「CV5314」の3倍となる72時間に達した。同社のアンダーフィル材料を使用した時と比べて、補強タクトタイムを約10分の1に縮められる。ジェットディスペンサーによる高速塗布にも対応する。
独自の樹脂設計を用いた流動性制御技術により、パッケージの外周に同材料を塗布することで、QFNに加えてアンダーフィルでは対応が難しかった25×25mm以上の大型BGAも実装補強できる。
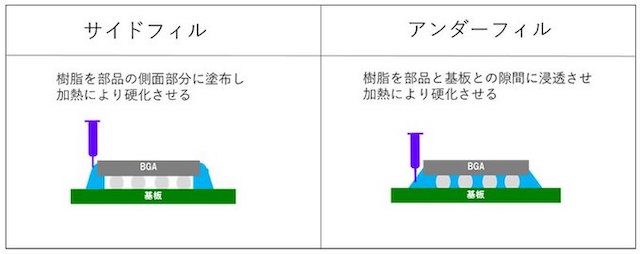
同社は、車載カメラモジュールや車載通信モジュール(ミリ波レーダー用モジュール)、車載ECU、次世代コックピット、ヘッドライトなどの半導体パッケージや電子デバイスにおける実装補強での用途を見込む。













