- 2021-6-23
- ニュース, 化学・素材系, 製品ニュース
- FC-BGA, サブストレート, パッケージ基板, パナソニック, パナソニック インダストリアルソリューションズ社, 低熱膨張率材料, 半導体, 半導体パッケージ基板材料, 基板材料
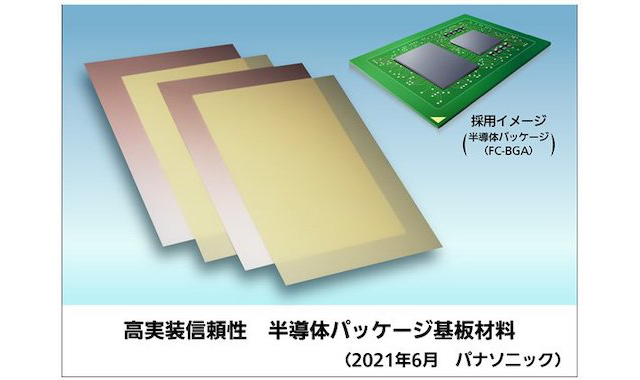
パナソニック インダストリアルソリューションズ社は2021年6月22日、実装時の反りやはんだボールへの応力を低減した半導体パッケージ基板材料「R-1515V」を製品化したと発表した。CPUやGPU、FPGA、ASICなどのFC-BGAパッケージ用途を想定しており、同年7月より量産を開始する。
半導体パッケージ基板材料の実装信頼性向上にあたっては、ICチップとサブストレートの実装(一次実装)時に反りの発生を抑え、半導体パッケージとマザーボードの実装(二次実装)時にはんだボールに生じる応力を低減することが求められる。
今回同社は、電子回路基板材料の開発で培った樹脂設計技術により、4ppm(同社測定値)の低熱膨張率材料を開発した。ICチップの低い熱膨張率に近づけたことで、反りの発生を抑えて一次実装の信頼性を高めている。
また、回路基板材料開発で培った樹脂流動制御技術により、樹脂流れを抑えつつ成形性を確保し、厚みのばらつきを低減した。ICチップとサブストレート(コア材)との接合を安定化し、一次実装の信頼性をさらに高めている。
加えて、シミュレーションを用いた独自の樹脂設計技術により、低熱膨張性を確保しながら伸縮性と緩衝性を両立した材料を開発した。半導体パッケージとマザーボードの間のはんだボールにかかる応力を緩和し、二次実装の信頼性も向上している。

ガラス転移温度は260℃で、比誘電率が4.4、誘電正接が0.016、弾性率が25℃で30GPa、250℃で14GPa、銅箔引き剥がし強さが0.6kN/mとなった(全て代表値、ガラス転移温度は評価サンプル板厚100μm、それ以外は評価サンプル板厚800μm)。板厚は、0.21〜1.8mmをラインアップに揃えている。