- 2021-8-15
- 制御・IT系, 技術ニュース, 海外ニュース
- Nature Electronics, UCLA, Yongjie Hu, コンピュータープロセッサ, ダイヤモンド, デバイス放熱技術, リン化ホウ素BP, 半導体材料, 学術, 炭化ケイ素, 熱スプレッダ材料, 砒化ホウ素BAs, 高出力コンピューターチップ, 高電子移動度トランジスター(HEMT)チップ
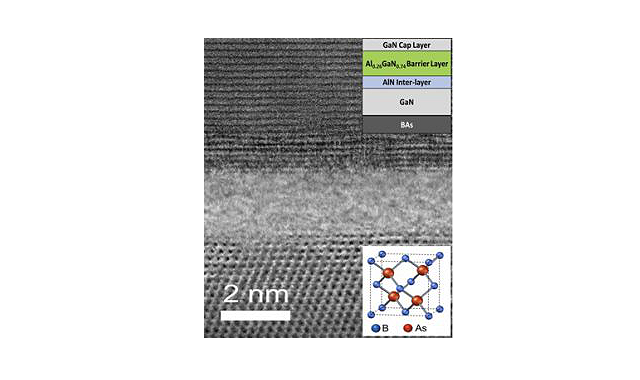
GaN半導体にBAs基板を熱スプレッダとして組込んだデバイスの電子顕微鏡写真/Credit: The H-Lab
UCLAの研究チームが、新たな半導体材料を高出力コンピューターチップに組込むことにより、チップの発熱を抑制してコンピューターの性能を高める可能性を示すことに成功した。コンピューターの過熱を防ぎ、エネルギー効率を顕著に向上できる新しい熱スプレッダ材料を開発したものであり、従来のデバイス放熱技術を超える熱マネジメント手法として期待される。研究成果が、2021年6月17日の『Nature Electronics』誌に論文公開されている。
近年、コンピュータープロセッサはナノメータサイズまで小さくなり、1つのチップに数10億個のトランジスタが搭載されているようになっている。トランジスタの数が増えるに従って、コンピューターは高速かつ高性能になる一方で、高密度化によって多くの発熱スポットを生じるようになっている。適切な熱マネジメント技術がない限り、プロセッサの作動速度が低下したり信頼性が劣化するとともに、過熱を防ぐために余計なエネルギーが必要になって、エネルギー効率が低下する問題を生じる。
このような問題を解決するために、UCLAの工学部機械宇宙航空工学科のYongjie Hu准教授が指導する研究チームは2018年、極めて高い熱伝導率を有する新しい半導体材料を開発した。欠陥のない砒化ホウ素(BAs)およびリン化ホウ素(BP)の半導体で、従来から放熱材料として活用されているダイヤモンドや炭化ケイ素の3倍以上の熱伝導率を示す。
そして研究チームは、BAs半導体をチップと放熱板の間に挿入することにより放熱効果を高める熱スプレッダとしてチップに組込み、実際のデバイスレベルでの熱マネジメント性能を確認する研究に取り組んだ。広バンドギャップGaN半導体にBAs基板を組込んだ結果、GaN/BAs界面の熱伝導率が250MW/m2Kと高く、界面熱抵抗が非常に小さいことを明らかにした。更に、AlGaN/GaNから構成される最先端の高電子移動度トランジスター(HEMT)チップにBAs基板を熱スプレッダとして組込み、ダイヤモンドや炭化ケイ素を用いた場合と比較して放熱効果が著しく優れていることを実証した。このチップを最大容量で作動させて、発熱スポットにおける常温からの最大温度上昇を測定した結果、熱スプレッダとしてダイヤモンドを用いたチップでは137℃、炭化ケイ素を用いたチップでは167℃であったのに対して、BAsを用いたチップでは87℃と極めて小さいことを確認した。研究チームは、このような界面における優れた熱伝導性は、「BAsの独特なフォノンバンド構造および界面の整合性に起因している」と、説明している。
「BAs材料は、熱伝導率が高いだけでなく界面における熱抵抗が小さいので、熱スプレッダとして用いることにより、従来よりも高いデバイス作動出力を実現できる。長距離大容量の無線通信など、高周波パワーエレクトロニクス分野に対して大きな可能性がある。将来的にエレクトロニクスパッケージにも応用できるだろう」と、Hu准教授は期待する。